勤友光電FOPLP/CoPoS 雷射剝離設備居世界領先地位
- 2025年7月17日
- 讀畢需時 2 分鐘
2025年7月17日
在AI應用爆發加速驅動高階封裝技術演進之際,勤友光電(KYO),高階封裝的Key Enabler憑藉其早期佈局,已在FOPLP(Fan-Out Panel Level Packaging)與CoPoS(Chip on Panel on Substrate)的關鍵設備:雷射剝離設備之領域站穩領導地位。自八年前便前瞻性投入panel type高階封裝設備的研發與投入,成功開發出具備世界級競爭力的Panel type Laser De-bonder(板級雷射剝離設備),成為高階封裝技術升級的關鍵推手。
目前FOPLP與CoPoS被視為次世代高階封裝的主流路線,日月光、力成等大型封裝廠為最早投入者,另群創也積極以FOPLP為轉型契機。今年初,台積電終也宣布將擴大投資CoPoS製程,採用310mm x 310mm的方形panel,視為其先進封裝技術由CoWoS邁向新世代的升級版本。
台積電董事長魏哲家日前指出,台積電先進封裝將由圓形轉為方形,主因在於隨著AI性能需求的提升,晶片尺寸持續擴大,傳統圓形封裝已面臨空間與成本瓶頸。扇出型面板級封裝FOPLP不僅可提升晶片整合密度,更具成本效益,成為支撐AI晶片量產的最佳解方。根據聯合報數位版透露,此技術將成為下一代先進封裝的主流。
據近日報導,日月光投控(3711)則鎖定600mm x 600mm及310mm x 310mm兩種panel尺寸,預計年底前可試量產。日月光營運長吳田玉表示,AI帶動的先進封裝需求正進入快速成長期,市況供不應求,公司將持續擴大投資「不會手軟」,他並預估今年整體營收有望年增10%。看好AI與半導體商機,兆豐銀主辦日月光500億元聯貸案,已獲1.5倍超額認貸,但事實是:面對百兆規模的AI市場,這仍僅是開始。
在此產業浪潮中,勤友光電展現技術領先優勢。早在12年前,即與IBM合作,開發將DPSS UV雷射應用於高階封裝設備,具有無熱影響、不損晶片線路的關鍵優勢,同時取得相關專利授權與相關的技術IP。
勤友光電創辦人暨榮譽董事長王位三,早年即展開國際合作與設備自研之路,以推動國產半導體設備自主化為己任,其遠見與投入鋪墊開展基石。現任董事長陳志政表示,公司長期投入研發已見成果,先期已成功推出300mm x 300mm與510mm x 515mm的UV Panel De-bonder,並於今年領先全球開發出最大尺寸的全自動600mm x 600mm FOPLP雷射剝離與清洗複合設備(Laser De-bonder + Wet Cleaner)。
此外,勤友光電也率先開發高階製程需求的的310mm x 310mm雷射剝離設備,並可向下兼容至300mm x 300mm,完整對應CoPoS製程。該設備有效解決封裝過程中細線路翹曲及應力釋放等技術瓶頸,有助加速CoPoS量產時程,為AI晶片製造與應用貢獻關鍵技術支持。
勤友光電以實績證明,台廠在先進封裝設備領域具備與歐美日大廠競爭的實力,未來將持續把握AI浪潮下的成長機會,推動台灣半導體設備登上國際舞台。



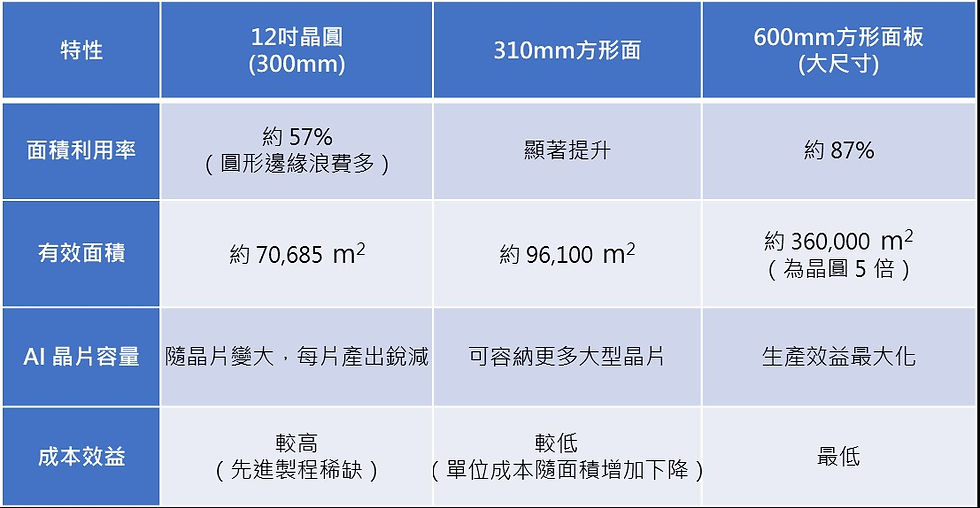

留言